Bestand:Illustration of C-V measurement.gif
Illustration_of_C-V_measurement.gif (322 × 308 pixels, bestandsgrootte: 93 kB, MIME-type: image/gif, herhalend, 18 frames, 5,4 s)
Bestandsgeschiedenis
Klik op een datum/tijd om het bestand te zien zoals het destijds was.
| Datum/tijd | Miniatuur | Afmetingen | Gebruiker | Opmerking | |
|---|---|---|---|---|---|
| huidige versie | 17 mei 2010 21:26 | 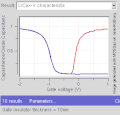 | 322 × 308 (93 kB) | Beatnik8983 | {{Information |Description={{en|1=C-V measurements can reveal oxide thickness, oxide charges, contamination from mobile ions, and interface trap density in wafer processes. In this image the C-V profile for a bulk p-type substrate MOSCAP with different ox |
Bestandsgebruik
Geen enkele pagina gebruikt dit bestand.
Globaal bestandsgebruik
De volgende andere wiki's gebruiken dit bestand:
- Gebruikt op en.wikipedia.org
- Gebruikt op fa.wikipedia.org
- Gebruikt op hu.wikipedia.org
- Gebruikt op ja.wikipedia.org
- Gebruikt op ru.wikipedia.org
- Gebruikt op zh.wikipedia.org

